
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
SiGe txiparen fabrikazioan: Albisteen txosten profesional bat
Material erdieroaleen bilakaera
Erdieroaleen teknologia modernoaren esparruan, miniaturizaziorako bultzada etengabeak silizioan oinarritutako material tradizionalen mugak gainditu ditu. Errendimendu handiko eta potentzia-kontsumo baxuko eskakizunei erantzuteko, SiGe (siliziozko germanioa) txip erdieroaleen fabrikazioan aukeratutako material konposatu gisa agertu da, bere propietate fisiko eta elektriko bereziengatik. Artikulu honek sakontzen duepitaxia prozesuaSiGe-ren eta hazkunde epitaxialean, tentsiozko silizio-aplikazioetan eta Gate-All-Around (GAA) egituretan.
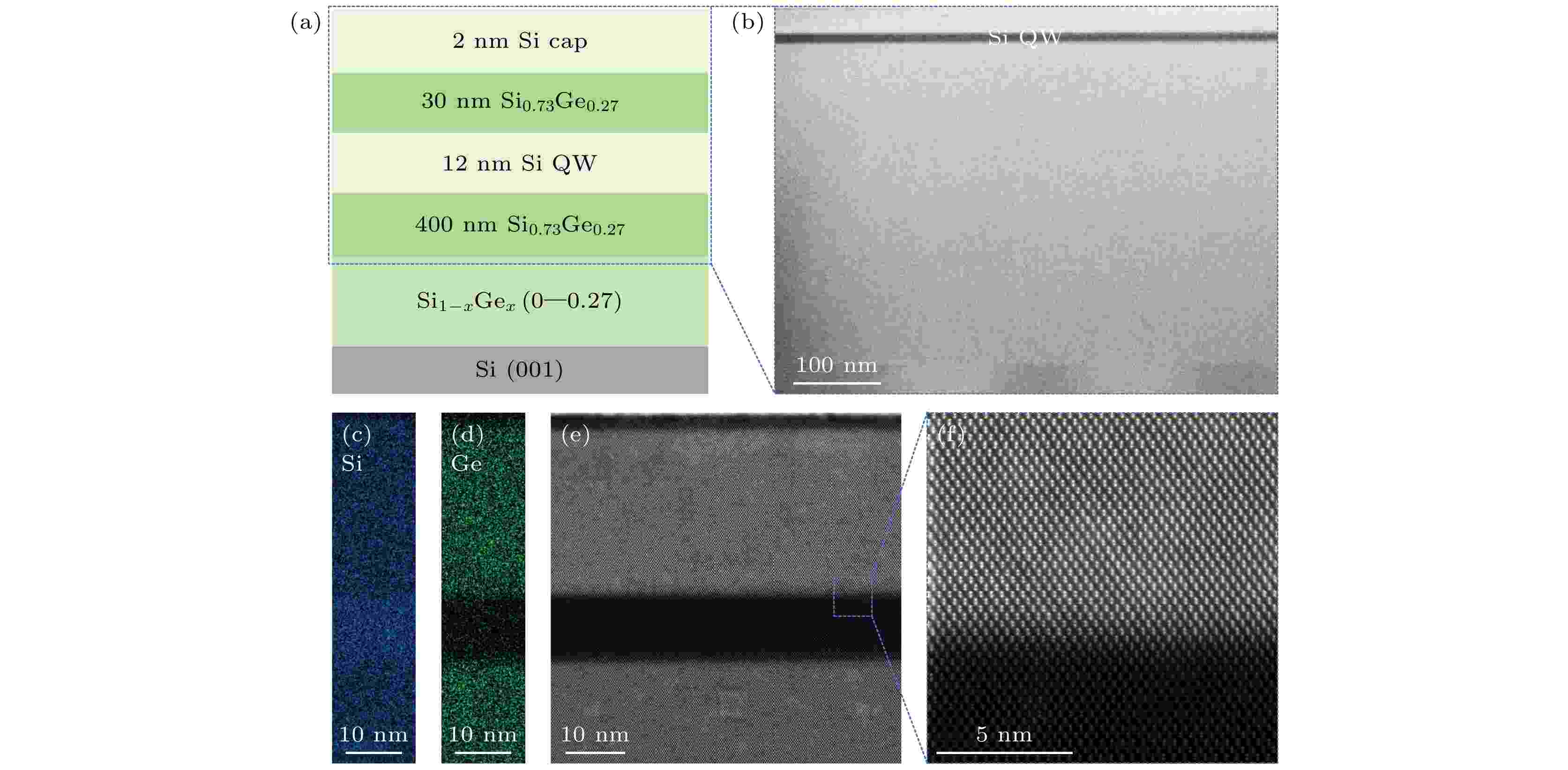
SiGe Epitaxiaren garrantzia
1.1 Epitaxiaren sarrera txiparen fabrikazioan:
Epitaxia, sarritan Epi gisa laburtua, kristal bakarreko geruza baten hazkuntzari egiten dio erreferentzia kristal bakarreko substratu batean, sare-antolaketa bera duen. Geruza hau bai izan daitekehomoepitaxiala (adibidez, Si/Si)edo heteroepitaxiala (esaterako, SiGe/Si edo SiC/Si). Hazkunde epitaxialerako hainbat metodo erabiltzen dira, besteak beste, Molecular Beam Epitaxia (MBE), Ultra-High Vacuum Chemical Bapor Deposition (UHV/CVD), Atmospheric and Reduced Pressure Epitaxia (ATM & RP Epi). Artikulu honek silizioaren (Si) eta silizio-germanioaren (SiGe) epitaxia prozesuetan oinarritzen da erdieroaleen zirkuitu integratuen ekoizpenean silizioa substratu-material gisa.
1.2 SiGe Epitaxiaren abantailak:
Germanioaren (Ge) proportzio jakin bat sartzeaepitaxia prozesuaSiGe kristal bakarreko geruza bat osatzen du, banda-zabalera murrizten ez ezik, transistorearen mozketa-maiztasuna (fT) areagotzen duena. Honek haririk gabeko eta optikoko komunikazioetarako maiztasun handiko gailuetan oso aplikagarria da. Gainera, CMOS zirkuitu integratuko prozesu aurreratuetan, Ge eta Siren arteko sare-desegokiak (% 4 inguru) sareko tentsioa sartzen du, elektroien edo zuloen mugikortasuna areagotuz eta horrela gailuaren saturazio-korrontea eta erantzun-abiadura handituz.
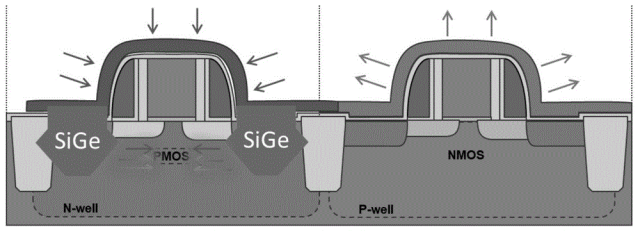
SiGe Epitaxia Prozesuaren Fluxu Integrala
2.1 Aurretratamendua:
Siliziozko obleak aldez aurretik tratatzen dira nahi diren prozesuko emaitzetan oinarrituta, batez ere obleen gainazaleko oxido-geruza naturala eta ezpurutasunak kentzen ditu. Asko dopatutako substratu-obleetarako, ezinbestekoa da kontuan hartzea atzeko zigilatzea beharrezkoa den ala ez autodopina murrizteko.epitaxia hazkundea.
2.2 Hazkunde-gasak eta baldintzak:
Silizio-gasak: silanoa (SiH₄), diklorosilanoa (DCS, SiH₂Cl₂) eta triklorosilanoa (TCS, SiHCl₃) dira gehien erabiltzen diren hiru gas iturriak. SiH₄ tenperatura baxuko epitaxia prozesu osoetarako egokia da, eta TCS, hazkuntza-tasa azkarragatik ezaguna den bitartean, oso erabilia da lodiak prestatzeko.silizio epitaxiageruzak.
Germanio gasa: Germane (GeH₄) germanioa gehitzeko iturri nagusia da, silizio iturriekin batera SiGe aleazioak osatzeko.
Epitaxia selektiboa: hazkunde selektiboaren tasa erlatiboak egokituz lortzen dadeposizio epitaxialaeta in situ grabatzea, kloroa duen silizio-gas DCS erabiliz. Selektibitatea silizioaren gainazalean Cl atomoen adsortzioa oxido edo nitruroetan baino txikiagoa izateagatik da, hazkunde epitaxiala erraztuz. SiH₄, Cl atomorik gabea eta aktibazio-energia baxua duena, orokorrean tenperatura baxuko epitaxia prozesu osoetan aplikatzen da. Erabilitako beste silizio-iturri bat, TCS, lurrun-presio baxua du eta likidoa da giro-tenperaturan, H₂ burbuila behar du erreakzio-ganbera sartzeko. Hala ere, nahiko merke da eta bere hazkuntza-tasa azkarragatik (5 μm/min arte) erabiltzen da silizio epitaxia geruza lodiagoak hazteko, silizio epitaxia obleen ekoizpenean oso erabilia.
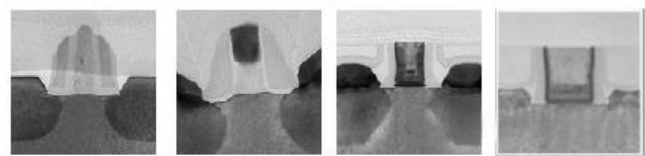
Silizio tentsioa geruza epitaxialetan
zeharhazkunde epitaxiala, kristal bakarreko Si epitaxiala SiGe geruza lasai batean metatzen da. Si eta SiGe-ren arteko sare-desegokia dela eta, Si-kristal bakarreko geruza azpiko SiGe geruzaren trakzio-esfortzua jasaten da, NMOS transistoreetan elektroien mugikortasuna nabarmen hobetuz. Teknologia honek saturazio-korrontea handitzeaz gain (Idsat) gailuaren erantzun-abiadura hobetzen du. PMOS gailuetarako, SiGe geruzak epitaxialki hazten dira iturri eta drainatze eskualdeetan grabatu ondoren kanalean konpresio-tentsioa sartzeko, zuloen mugikortasuna hobetuz eta saturazio-korrontea areagotuz.
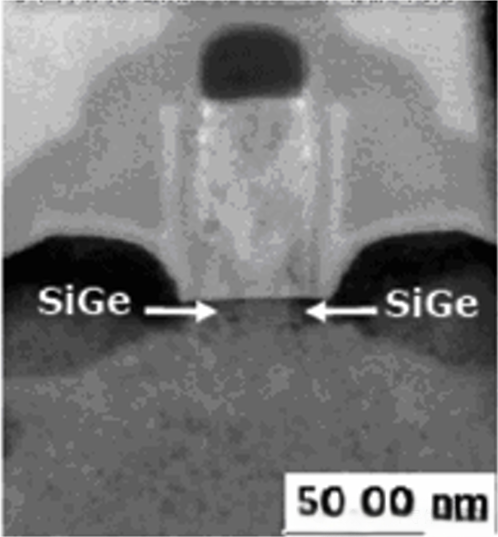
SiGe Sakrifizio Geruza gisa GAA Egituretan
Gate-All-Around (GAA) nanoharileko transistoreen fabrikazioan, SiGe geruzek sakrifizio geruza gisa jokatzen dute. Selektibitate handiko grabatze anisotropiko teknikek, hala nola, geruza ia-atomikoko grabaketa (quasi-ALE), SiGe geruzak zehatz-mehatz kentzea ahalbidetzen dute nanohari edo nanoxafla egiturak osatzeko.
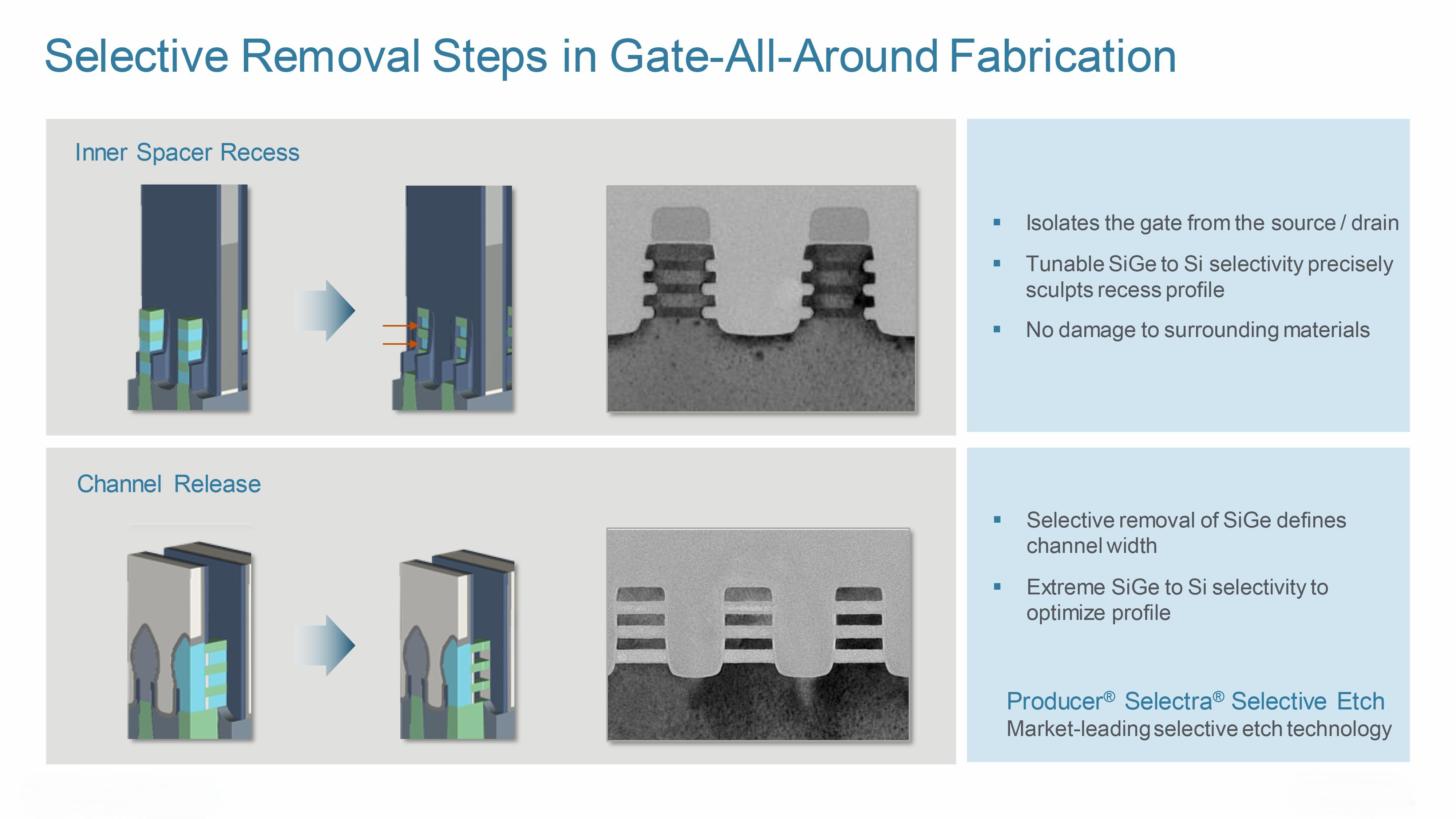
Semicorex-en espezializatuta gaudeSiC/TaC estalitako grafito-disoluzioakErdieroaleen fabrikazioan Si epitaxial hazkundean aplikatuta, edozein kontsulta baduzu edo xehetasun gehiago behar badituzu, ez izan zalantzarik gurekin harremanetan jartzeko.
Harremanetarako telefonoa: +86-13567891907
Posta elektronikoa: sales@semicorex.com




